在红外热成像领域,探测器作为核心元器件,其性能表现对终端产品的成像质量、可靠性和应用范围有深刻影响。而封装形式则直接决定了探测器的可靠性、体积、性能与成本。当前红外行业主流封装方式中,虽然金属封装、陶瓷封装和晶圆级封装(WLP)并存,但整体上封装技术的迭代是朝着“更小体积、更高可靠性、更低成本和更高集成度”的方向发展。
封装方式对红外探测器的影响
可靠性保障:红外芯片对水汽、粉尘、机械冲击等外部环境极为敏感,封装需建立稳定的保护屏障,同时满足高真空的要求,避免芯片性能衰减或失效;
性能优化:封装的热导率直接影响芯片散热效率,散热不良会导致芯片噪声增大、探测精度下降;
集成适配性:封装的体积、重量及接口决定探测器能否适配不同应用场景的集成需求;
成本控制:封装的材料选择和制程的复杂度影响探测器的量产效率与单位成本,成本的差异极大影响了红外热成像技术的普及程度。
主流封装技术介绍

当前红外行业主流封装方式包括:金属封装、陶瓷封装、晶圆级封装(WLP)及超级晶圆级封装(SWLP),四种技术路径各有侧重,分别适配不同层级的应用需求。
金属封装:传统可靠的“防护卫士”

金属封装是红外探测器最早采用的封装形式之一,通过金属管壳将芯片与外部空间进行隔离,构建密闭的防护环境,保护芯片并满足对真空工作环境的要求。
核心特点:机械强度极高,能抵御剧烈冲击与振动;热导率优异,散热性能突出;密封性能好,可靠性强。但金属封装短板同样明显,金属材料成本高,制程工艺复杂,封装后的探测器体积大、重量沉,难以满足小型化需求。
应用场景:主要适配对可靠性和散热要求极高、以及对体积重量不敏感的场景。
陶瓷封装:平衡性能与成本的“中坚力量”
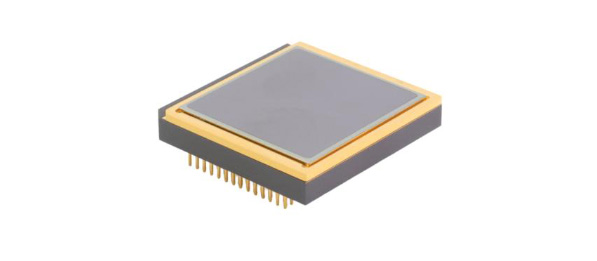
相比于金属封装,陶瓷封装将管壳从金属变为陶瓷,在保持一定强度和可靠性的同时,实现轻量化与成本优化,在高端器件中应用广泛。
核心特点:兼顾良好的机械稳定性与热稳定性,密封性能接近金属封装。相较于金属封装,体积和重量显著减小,更易集成,但成本仍较高,制造工艺复杂,封装后尺寸仍偏大。
应用场景:广泛应用于对性能、可靠性有较高要求,且需要一定集成度的场景。
晶圆级封装(WLP):极致小型化的 “突破者”

晶圆级封装是封装技术的革命性突破。WLP无多余壳体,将窗口与芯片直接封装,并将封装过程前移到晶圆阶段完成,是迈向先进封装的重要一步。
核心特点:实现极致的小型化与轻量化,封装尺寸与芯片本身接近;可实现大规模批量生产,制造效率大幅提升,成本显著降低。但局限性在于封装流程复杂,后封装产线固定资产投入成本高,对生产环境的洁净度要求极高。
应用场景:适配对体积、重量和成本敏感的小型化设备。
超级晶圆级封装(SWLP):系统集成的 “革新者”

SWLP是在WLP基础上演进而来的更高级形态,核心思路是对WLP封装的痛点做针对性改善,通过结构优化实现更高的集成度与可扩展性。
核心特点:继承 WLP 极致小型化、轻量化的优势;完成电信号引出,无需单独打线;封装具备防尘防颗粒性能,打破了 WLP 对生产环境的严苛限制,常规环境即可集成;匹配 SMT 贴装技术,快速批量生产。
应用场景:广泛适配体积、重量和成本敏感的小型化设备。SWLP技术极大降低行业准入门槛,让更多企业可以自主实现机芯模组的研发制造。
未来封装方式的发展方向
从“笨重”的金属/陶瓷封装,到“更小更快”的 WLP,再到“高集成、可扩展、系统级”的 SWLP,非制冷红外焦平面探测器的封装技术始终围绕“功能升级与场景适配”迭代。
系统级集成深化
封装技术将不再局限于“保护芯片”的单一功能,而是朝着“集成多组件、重构系统架构”的方向发展。
极致小型化与轻量化
随着红外热成像技术向消费电子、便携式设备、民用无人机等场景渗透,对器件的小型化、轻量化要求更高。未来封装技术将进一步缩小尺寸与重量,让探测器能够嵌入更微小的终端设备中,持续拓展红外技术的应用边界。
低成本与高可靠性平衡
非制冷红外焦平面探测器的封装技术进化史,本质上是一场“性能、体积、成本、集成度”的平衡艺术。从传统金属封装到先进的SWLP,每一次技术突破都推动着红外技术向更广泛的领域渗透。未来,随着系统集成深化、小型化升级与成本优化的持续推进,红外技术将真正赋能千行百业。
新品预告
2025年,睿创微电子发布全球首款SWLP探测器OHLE3123,面阵384×288,像元间距12微米,尺寸10.4×10.4mm。
今年,我们即将推出第二款SWLP探测器,面阵640×512,像元间距8微米,猜猜尺寸可以做到多少呢?
如您有更多探测器需求,欢迎网站联系我们!





